오늘날 차량에 탑재되는 전자 장치의 양은 빠르게 증가하고 있고 자율 주행 산업이 점점 커지면서 기능 안전 표준을 엄격히 충족해야 하며, 기능 안전 기능은 그 어느 때보다 중요합니다.
따라서 ISO26262 표준에 따라 커넥티드 차량과 자율주행 차량의 공유 이동성 및 전자화라는 새로운 트렌드로 인해 자동차 전자 장치는 더욱 안전하고 신뢰할 수 있어야 합니다.
기능 안전은 제품의 전반적인 안전의 일부로, 올바른 입력을 얻고, 처리하고, 올바른 출력을 제공하는 데 중점을 둡니다.
위험 측면에서는 E/E 시스템의 오작동으로 인한 불합리한 위험을 방지해야 합니다.
FMEDA는 하드웨어 설계에 필수적인 안전분석 기법 중 하나이며, Failure Rate(FIT)은 FMEDA 분석 기법에 중요한 입력 요소이며, 본 레터는 Failure Rate를 계산하는 다양한 방법을 살펴보도록 하겠습니다.
SN29500, IEC TR 62380, HTOL에 따른 기능안전 BFR 기본 Failure Rate 적용에 따른 산업 출처 적용 이해 방안
Quantitative Random for Hardware Failure Metrics (Safety Analysis : FMEDA)
ISO26262-5에서는 하드웨어 안전 요구사항, 하드웨어 아키텍처, 하드웨어 설계, 안전 분석, 검증 및 테스트에 대한 지침을 제공합니다.
하드웨어 안전 분석은 정성적 분석(FMEA)과 정량적 분석(FMEDA)을 포함하며, FTA는 정성/정량적 분석 모두 이루어 질 수 있으며, 본 레터에서는 FMEDA 분석을 중심으로 설명하고자 합니다.
Random HW Failure Over Lifetime and Estimation of BFR
System Integrator는 Wear Out이 시작 될 뿐만 아니라 정상적인 동작 시간 (Normal Life Failure) 안에 Random HW Failure를 고려해야 하며, 안전 메커니즘을 통해 진단 범위를 제공하고 허용 가능한 값으로 고장율을 낮춰야 합니다.
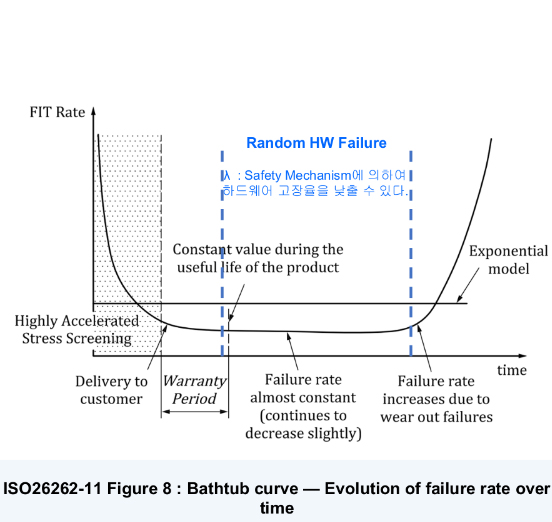
하드웨어 우발 고장(Random failure) 이란?
하드웨어 엘리먼트의 수명 내에서 예측 불가능하게 발생하는 고장으로서, 확률 분포를 따른다.
제조사 입장에서 볼 때 안전 설계가 이루어 지더라도, 고장이 언제 일어날지는 예측 불가.
(사용자에 의한 오용이 대표적인 사례가 될 수 있음)
대부분의 하드웨어 결함은 안전 분석을 통해서 식별되고 안전 메커니즘으로 회피 또는 방지됨.
단, 안전 분석에서 식별 되지 못한 결함이나, 안전 메커니즘이 커버하지 못한 결함(잔존결함)이 존재.
또한, 소자 자체의 고장율로 인한 우발 고장 발생 존재.
- Normal Life Failure (Constant Random Failure) : 1 FIT는 부품의 10억 작동 시간 동안 1번의 오류가 발생 했음을 의미.
- BFR은 반도체 부품의 Lifecycle을 다루며, FIT (Failure In Time)단위로 정량화.
- FIT는 부품의 수명인 Constant Failure Rate 영역에서의 고장 횟수를 의미함.
Systematic Failure vs Random Failure
Systematic Failure와 Random Hardware Failure은 시스템 안전성과 신뢰성에 밀접한 관련이 있으며, 각각 다른 유형의 실패로 시스템의 안전성을 위협할 수 있으며, ISO2626-5에서는 이러한 두가지 유형을 모두 고려하여 기능안전을 보장하기 위한 프로세스 및 절차를 정의하고 있습니다. 본 레터에서는 Random HW Failure에 초점을 맞추어 설명하도록 하겠습니다.
① Systematic Failure (Deterministic)
- 설계 또는 공정 프로세스, 운영 절차, 문서화와 같이 프로세스 측면의 개선을 통해서 제거될 수 있는 요인들에 의해 인과 관계로 나타나는 고장
Example : 누락되거나 잘못된 요구 사항, 잘못된 테스트 사례
(Silicon Bug는 개발 Verification 단계에서 감지 할 수 있으므로 대표적인 Systematic Failure 이다) - Automotive를 설계하고 엄격한 개발 프로세스를 준수함으로써 시스템적 결함을 관리하고 완화할 수 있으며, 지속적인 프로세스 개선을 통해 설계 검토 중에 잘못되거나 누락된 원인을 제거할 수 있다. (ISO9001 품질경영시스템 준수)
② Random HW Failure (Unpredictably)
- 하드웨어 엘리먼트의 수명주기 동안 예측 불가능하게 나타나는 고장을 가리키며 확률 분포를 따름
- Random HW Failure는 모든 전자 시스템은 결국 다양한 이유로 HW Failure가 발생한다는 가정에서 완전히 제거 할 수 없으며 Automotive E/E 시스템의 경우, 운전자에게 Fault를 경고하면 Random HW Failure를 어느정도 Failure를 감지하고 예방 할 수 있어야 함.

※ FMEDA : Failure Mode Effects Diagnostic Analysis
BFR Estimation Techniques
BFR을 추정하기 위해 아래와 같이 다양한 기법 존재하며, 본 레터에서는 BFR을 추정하기 위해 SN29500와
IEC TR 62380 그리고 HTOL을 중점으로 설명하고자 합니다.
- Recognized Industry standards: Commonly used and recognized standards include
IEC TR 62380 and IEC 61709
SN 29500, the Siemens AG standard for the reliability prediction of E/E components
FIDES such as a military handbook or other documentation from a credible source - High Temperature Operation Lifetime (HTOL) tests
(Temperature Bias Operating Lifetime test, Extended life reliability test) - Statistics based on field returns
- Expert Judgment
SN29500 FIT Model
SN29500은 다음과 같은 Look Up Table을 참고하여 다양한 컴포넌트의 FIT를 도출한다.
- Integrated circuits (ICs)
- Discrete semiconductors
- Passive components
- Switches, relays, lamps, connectors, and so on
4가지 유형으로 IC 및 Component Type에 따라 아래와 같이 세분화 되며, System Integrators는 SN29500 표준 테이블을 참고하여 해당 Application의 특정 FIT를 도출해야 합니다.
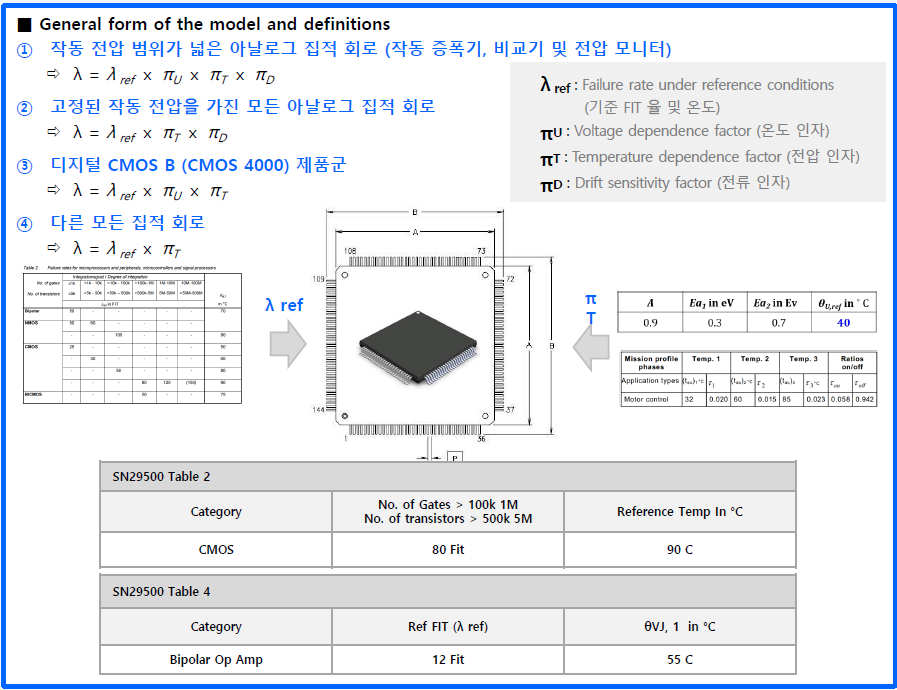
IEC TR 62380 FIT Model
IEC 62380은 기능안전 분석에 BFR 추정 할 때에 일반적으로 사용되며, 전자부품의 신뢰성을 예측하기 위한 보편적인 모델을 설명하는 신뢰성 데이터 핸드북입니다.
IEC 62380은 2004년에 발행 되었으며, ISO26262 표준(2018, 2nd 개정)에 Part 11 반도체에 대한 적용 지침에 일부로 IC 고장율은 Die, Package, Overstress 관련 고장율의 합으로 모델링 할 수 있음.

- ?die 의 고장율 공식은 IC Type 및 IC Technology, Transistor 개수, Thermal Mission Profile, Junction Temperature와 작동 및 비작동 수명에 대한 조건 포함
- ?pkg 의 고장율 공식은 열 팽창, 열주기, Thermal Mission Profile, Package 등에 대한 조건 포함
- ?overstress 의 고장율 공식은 외부 인터페이스와 전기적 환경을 갖춘 특정 시스템 조건 포함
HTOL (High Temperature Operation Lifetime) FIT Model
HTOK은 고온에서 작동하는 전자기기나 반도체의 수명을 평가하는데 사용되며, 고온에서 장기간 동안 수명이 어떻게 영향을 받는지 영향을 예측하고 설계 개선을 위한 정보를 얻을 수 있음

BFR Difference SN29500 and IEC TR 62380 and HTOL
- SN29500와 HTOL은 Silicon 과 Package 상호 작용으로 인해 발생하는 오류를 설명하는데 부족합니다.
- 기능안전 표준에서는 반도채 부품 Package 재료 및 Silicon, Package 연결 핀과 Silicon 상호 작용으로 인해 발생 하는 오류를 추정 합니다.
- System Integrator는 반드시 반도체 부품과 보드사이의 연결 지점 (납땜 접합부)으로 인해 발생하는 오류를 설명하며, 이러한 Failure는 일반적으로 Element 또는 시스템 수준에서 분석됩니다.
- IEC TR 62380은 Silicon die 와 Lead Frame와 기판사이의 상호 작용과 Solder Joint 사이의 연결을 모두 설명하나, SN29500은 Package 와 die 상호 작용만 고려하고 HTOL은 Silicon 오류만 설명하고 Silicon 및 Package 상호 작용으로 인한 조건은 무시하며, Test Variables를 제조 업체에 유리하게 적용 될 수 있기에, IEC TR 62380 와 SN29500 규격 대비 사용을 권고하지 않습니다.
Guide to BFR Selection
ISO26262-5에서 Systematic Failure 및 Random Failure를 구분하고 각각의 대책을 세우고, Random Failure 에 대한 분석은 제품이 가지고 있는 안전 메커니즘(Safety Mechanism)에 의해 제한 시간내에 검출 및 조치를 해야 하며,
FMEDA를 통해 ASIL 만족하고 결정하는 중요한 지표가 됩니다.
자동차 전장부품의 BFR 산정기준은 아래와 같이 우선순위가 존재하고, 산업 출처에 의해 BFR이 결정 됩니다.
- 고객이 지정한 BFR 적용 (SN29500, IEC TR 62380, MIL-HDBK-217F, HTOL 등)
(우선 순위 사용 빈도 : SN29500, IEC TR 62380 - 고객이 지정한 고장율 / 고장모드 데이터북을 참조하여 BFR을 계산
- 부품 제조사에서 제공하는 BFR을 적용
(단, 이 경우 BFR을 적용한 환경변수 값(Mission Profile)이 실제 값과 크게 다를 경우에는 고객이 별도로 명시한 고장율 데이터북을 참조하거나 자체 자료를 참조하여 계산해야 합니다.)
[Reference]
- SN 29500 (2004), Siemens AG, Failure Rates of Components — Expected Values, General
- ISO 26262-11:2018, Road Vehicles — Functional safety — Part 11: Guideline on application of ISO 26262 on semiconductors
- JESD85A METHODS FOR CALCULATING FAILURE RATES IN UNITS OF FITS
- IEC/TR 62380:2004(E): Reliability data handbook – Universal model for reliability prediction of electronic components, PCBs and equipment
- Understanding Functional Safety FIT Base Failure Rate – Texas Instruments